EUV-IUCC
EUV lithography는
1981년에 연구가 시작되어 38년만인 2019년 7nm급 반도체 양산에
적용되기 시작한 최첨단 노광기술입니다. 그러나 아직 해결되지 못한
핵심기술이 남아 있어 지속적인 연구개발이 필요합니다.
IUCC는
‘Industry and University Collaboration Center’의 약자로
‘EUV공정기술의 완성’이라는 공통의 목표를 향해 산학연이 함께 노력하는 곳 입니다.
EUV-IUCC는 EUV 기술 선도자로서 전문 지식을 바탕으로 더 나은 공정 솔루션 제공을
위한 기반을 만들고자 합니다.
EUV-IUCC는 기반 기술 연구와 그 결과 공유를 통해 산업계를 지원하는
EUV 기술 중추 역할을 하겠습니다.

-
01
EUV lithography
EUVL은 13.5 nm 파장의 EUV 광을 사용하여 sub 7 nm node 초미세 반도체 소자 회로를
구현하기 위한 최고의 노광 기술입니다. 대기를 포함한 대부분의 물질에 대해 쉽게 흡수되어
기존의 노광 기술들이 투과형 광학계를 사용하는 것과 달리 모든 광학계가 반사형으로
구성되므로 광원이 일정 각도를 갖고 마스크에 사입사 하는 것이 특징입니다.
이러한 이유로 모든 요소 기술들이 기존의 노광 기술과 완전히 다른 방식으로
개발되어야 합니다.

-
02
EUV photomask
Optical lithography에서는 photomask에 새겨진 설계회로를 빛을 통해 웨이퍼에
축소 투영하여 회로 패턴을 구현합니다. EUVL에서는 기존 노광 기술과 달리
반사형 구조로 제작되는데 이는 mask 3D effect라는 심각한 문제를 야기합니다.
이로 인한 노광 특성의 저하를 막기 위해 새로운 소재 및 구조의 EUV mask 연구 개발이
활발히 진행 중에 있습니다.
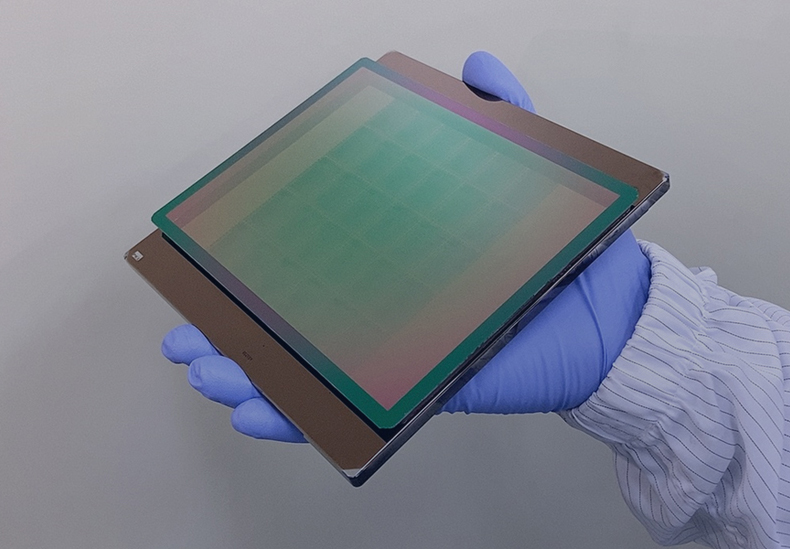
-
03
EUV pellicle
노광 해상도가 점차 향상됨에 따라 nm 크기의 오염물질을 통해서도 웨이퍼 패턴 손실이
야기될 수 있습니다. 공정 중 발생하는 외부 오염물질로부터 EUV mask를 보호하여
수율 저하를 방지하기 위해 pellicle이 사용되어 왔으나 EUVL에서는 극악의 기술 개발
난이도를 요하는 기술로 유일하게 상용화된 제품이 없습니다. 현재 업계의 요구에 맞는
광학적, 열적, 기계적 특성이 우수한 EUV pellicle연구 개발이 활발히 이루어지고 있습니다.
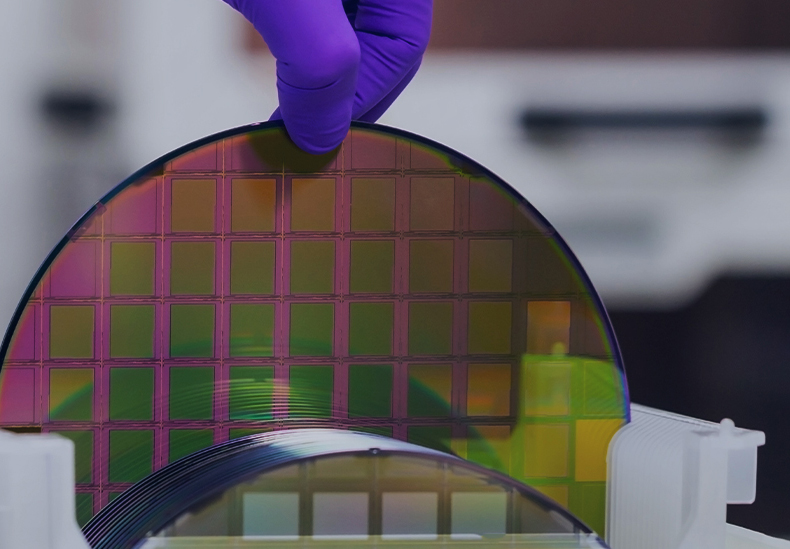
-
04
EUV resist
웨이퍼 패턴 형성에 핵심적인 역할을 하는 Photo resist (PR)는 노광 공정 전체의
생산성 및 제품 성능과 직결됩니다. 해상도, 선폭 거칠기 및 감도는 PR에 요구되는
주요 특성들입니다. 이외에도 특히 stochastic effect 완화라는 매우 중요한 이슈를
고려한 EUV resist 개발이 필요합니다.
EUV-IUCC News
EUV-IUCC 소식을 전해드립니다.
-
 Data Room
Data Room2023 VLSI Sympo workshop2 EUV Litho Path to HNA EUV 230717
-
 Data Room
Data RoomSAMSUNG 3D DRAM_VLSI2023 Sympo. 발표 paper _230717
-
 Data Room
Data RoomVLSI Symposium 2023 기술내용 사전 Preview_230612
-
 Data Room
Data Room나노종합기술원(NNFC) 연구개발지원 설명회 자료_20230526
-
 Data Room
Data RoomEUV-IUCC 산학기술교류회(5/18) Activity 발표_20230518
-
 Data Room
Data RoomA Vision And Strategy For The National Semiconductor Technology Cente (NSTC)_230325
-
 Data Room
Data RoomPhotolithography equipment market and technology: State and challenges_230228
-
 Data Room
Data RoomSPIE2023 Advanced Lithography Proceeding material(1회차)
-
 Data Room
Data RoomASML Investor Relations Q1 2023_230419
-
 Data Room
Data RoomK-chips Webzine (1호)_2023.03.09
-
 Data Room
Data Room2023 Applied Material_ New Ways to Shrink Advanced Patterning Product_20230228
-
Data Room
2023년 CES 기술동향 및 글로벌 유망기술 메가트렌드 소개_230310
































